JFE-TEC News
No.05「レーザICP質量分析法(LA-ICP-MS)による局所・表面分析」
JFE-TEC News No.05号 レーザICP質量分析法(LA-ICP-MS)による局所・表面分析 他 記事一覧
レーザICP質量分析法(LA-ICP-MS)による局所・表面分析
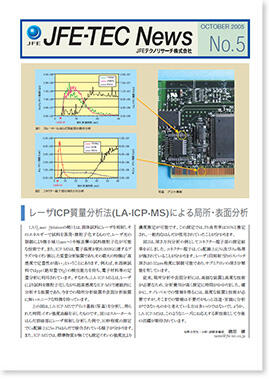
全文 PDF (117.8 KB)
No.05 レーザICP質量分析法(LA-ICP-MS)による局所・表面分析 他
レーザICP質量分析法(LA-ICP-MS)による局所・表面分析
LA(Laser A blationの略)とは、固体試料にレーザを照射しそのエネルギーで試料を蒸発・微粒子化するもので、レーザ光の制御により微小域(5μm~)や極表層の試料微粒子化が可能な技術です。また、ICP-MSは、電子温度が約9,000Kに達するプラズマをイオン源とした質量分析装置であり、その最大の特徴は「高感度で定量性が高い」ということにあります。例えば、水溶液試料ではpp(t 絶対量でfg)の検出能力を持ち、電子材料等の定量分析に利用されています。すなわち、LA-ICP-MSとは、レーザにより試料を微粒子化しながら超高感度なICP-MSで連続的に分析する装置であり、今までの局所分析装置や表面分析装置に無いユニークな特徴を持っています。
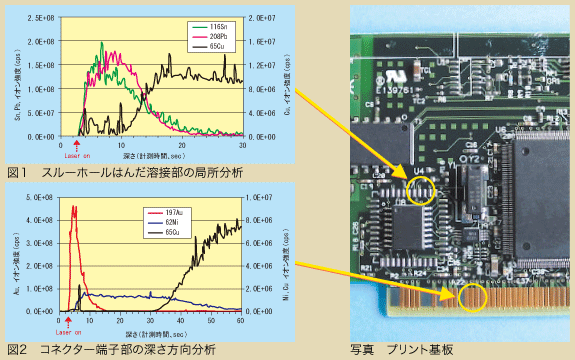
図1 スルーホールはんだ溶接部の局所分析(左上) 図2 コネクター端子部の深さ方向分析(左下)
写真 プリント基板(右)
上の図は、LA-ICP-MSでプリント基板(写真)を分析し、得られた時間-イオン強度曲線を示したものです。図1はスルーホールはんだ溶接部にレーザ照射し分析した例で、30秒程度の測定でCu配線上にSn-Pbはんだで接合されている様子が分かります。また、ICP-MSでは、標準物質が無くても測定イオンの強度比より濃度推定が可能です。この測定では、Pb含有率は30%と推定され、一般的なはんだが使用されていたことが分かります。
図2は、深さ方向分析の例としてコネクター端子部の測定結果を示しました。コネクター端子は、Cu配線上にNi及びAu処理が施されていることが分かります。レーザ1回照射当りのスパッタ深さは0.02μm程度に制御可能であり、サブミクロンの深さ分解能を有しています。
従来、局所分析や表面分析には、高価な装置と高度な技術が必要なため、分析費用が高く測定に時間がかかりました。確かに、ナノレベルでの情報を得るには、高度な装置と技術が必要ですが、そこまでの情報は不要だがもっと迅速・安価に分析ができないものかと考えている方は多いのではないでしょうか。LA-ICP-MSは、このようなニーズにお応えする新技術として今後の活躍が期待されています。
関連リンク・関連記事
このページに関する
お問い合わせはこちらから
- JFEテクノリサーチ株式会社 営業本部
- 0120-643-777


