JFE-TEC News
No.34「クライオ機能を活用した電子顕微鏡観察用の試料作製技術」
JFE-TEC News No.34号 クライオ機能を活用した電子顕微鏡観察用の試料作製技術 他 記事一覧
クライオ機能を活用した電子顕微鏡観察用の試料作製技術

全文 PDF (1.3 MB)
No.34 クライオ機能を活用した電子顕微鏡観察用の試料作製技術 他
クライオ機能を活用した電子顕微鏡観察用の試料作製技術~クライオミクロトーム/クライオイオンビーム加工技術~
Sample Preparation Technique by Cryogenic Processing for Electron Microscope
高分子材料やパワー半導体などの機能性材料において、走査電子顕微鏡(SEM)や透過電子顕微鏡(TEM)による試料断面の微視的な組織観察はきわめて重要です。ミクロトーム切削法やイオンビーム加工法は、研磨剤や洗浄による試料の汚染がなく平滑な観察面に仕上げることができるため、一般的に用いられる試料作製技術です。しかしミクロトーム切削法では、樹脂などの軟質材料の場合は切削時に試料が変形したり、イオンビーム加工法では、Gaなどの一次イオンが打ち込まれることによる結晶欠陥や発熱による変質(溶融、反応等)が生じるという問題が指摘されていました。これらの問題を解決するために、この度、当社はミクロトームおよびイオンビーム加工装置にクライオ機能を付加しました。
クライオミクロトーム加工技術
高分子材料の多くは、-100 ~ -200℃の間にガラス転移点をもち、これより低温では硬度が上昇します。図1は粘着ゴムシートを約-100℃に凍結し、ミクロトーム切削加工した面のSEM像です。この試料には繊維組織が存在しますが、常温加工したものと比較すると、凍結させた場合は繊維が変形することなく切削できています。
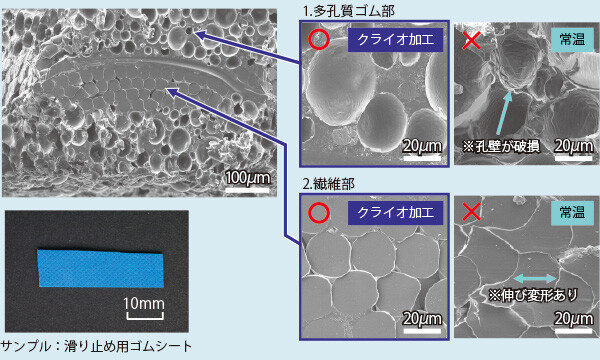
図1 クライオミクロトーム切削法により加工した
滑り止め用ゴムシート断面のSEM観察結果
クライオ集束イオンビーム(FIB) 加工技術
GaN系の化合物半導体は、LEDや次世代のパワー半導体として注目されており、TEMにより多層構造の解析や欠陥解析が行われています。半導体の薄膜試料加工には、FIBが用いられます。GaN系半導体はイオンダメージが起こりやすい材料として知られています。図2はサファイア基板上に成長させたGaN系半導体を、クライオ条件と常温条件でFIB加工したTEM像です。常温で加工した試料では、欠陥に起因した斑点状のコントラストが試料全体に存在していますが、クライオ加工した試料の場合は欠陥によるコントラストはほとんど認められていません。
クライオ加工技術を活用し、さまざまな分野からの試料調整や組織観察のご要望にお応えいたします。
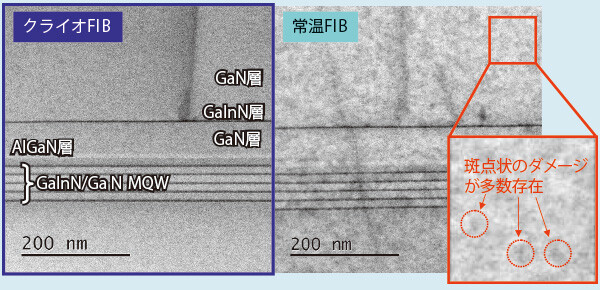
図2 クライオFIB法により加工したGaN積層膜断面
のSTEM (走査透過電子顕微鏡) 観察結果
関連リンク・関連記事
このページに関する
お問い合わせはこちらから
- JFEテクノリサーチ株式会社 営業本部
- 0120-643-777


