トータルソリューション
電子部品、電子デバイスの解析・調査
電子部品、電子デバイスの解析・調査の概要
-
SiC系など次世代のパワーデバイスの開発のための、ウエハの分析、チップ構造の微細構造、モジュールの調査を行います。
また、LSI製品、電子部品単体、実装基板、電子部品のトラブル及び不具合についての原因解析を受託し、お客様の品質管理、製品開発の効率化に寄与するとともに製品歩留まり向上を支援致します。豊富な実績に裏づけされたノウハウ蓄積により、効率的な調査ならびに迅速な対応で皆様の課題解決にお応えします。
鉛フリー化にともなうはんだ接合部の信頼性評価など、迅速・的確に対応します。
-
動画配信中!

※音声はミュート設定になっております。
事故原因究明、調査、解析が実績のある産業分野
- 自動車(ハーネス、制御機器、モータ部品、電源ユニット、他)
- 航空機、エレクトロニクス、家電、日用品、産業機械、医療器具、保安部品等
電子部品及びプリント基板実装品の調査事例
-

-

-
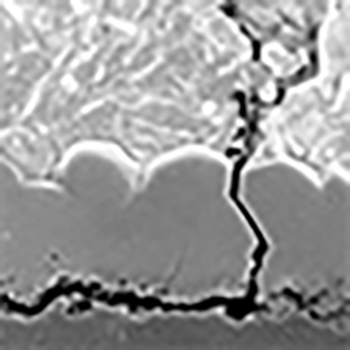
-
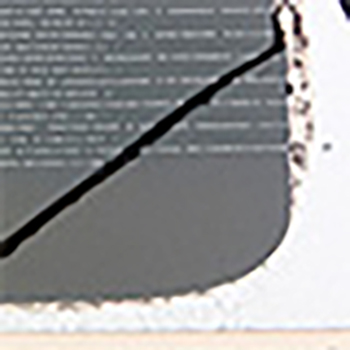
-

-

- コネクタ不具合事例
-
- Auめっきポアコロージョン
- Snめっきフレッティング
- 異種金属接触腐食
-

- 電解コンデンサ
-
- 電解液漏れ
- 開弁
-

- プリント基板の不具合事例
-
- スルーホール、配線不具合
- ブラックパッド現象
- ソルダーレジスト未硬化
-

- 水晶振動子
-
- 電極接続不具合
- 振動子破壊
電子部品、電子デバイスのおもな試験項目例
各種環境試験(信頼性試験)
-
- 熱衝撃試験
- 恒温恒湿試験
- プレッシャークッカー試験
-
- 低温保存試験
- ESD耐圧試験
はんだ等の接合
-
- 耐久試験
- 濡れ性試験
- リフロー耐熱試験
-
- 剥離強度試験
- ボンディングワイヤのプル・シェア試験
非破壊検査
-
- 透過X線観察
- X線分析顕微鏡測定
-
- 超音波探傷観察
- X線CT観察
解析時の試料前処理
-
- FIB法
- ワイヤーソー切断
-
- パッケージ開封
- 20μm程度までの精密研磨
電気的特性評価
-
- 体積抵抗率測定
- V-I特性
-
- 層間抵抗測定
パワーデバイスの評価項目
SiCウエハ・エピ層の欠陥評価の不純物分析、デバイスの微細構造解析、実装モジュールの解析を行います。
電子部品、電子デバイスの解析・調査ソリューションの要素となる技術
作業の流れ

関連ページ・関連リンク
- 高温絶縁油中における高分子材料の絶縁破壊試験 [事例集PDF]
- 半導体製品の正規品との比較調査サービス [事例集PDF]
- 振動試験中の電子基板の振動可視化技術 [事例集PDF]
- コネクター部品の環境制御振動試験・接触不良原因調査 [事例集PDF]
- 電動車駆動モータ絶縁材料の評価・解析 [事例集PDF]
- ガス腐食試験による電子部品の環境分類適合性評価 [事例集PDF]
- はんだリフロープロセスにおける基板温度解析 [事例集PDF]
- 電子基板の高速・高精細温度計測 [事例集PDF]
- 電子部品などの微小試料の蛍光X線分析 [事例集PDF]
- ULV-SEMによる電子部品用放熱シートの構造解析 [事例集PDF]
- ガス腐食試験による電子部品の寿命推定 [事例集PDF]
- FE-EPMA(電界放出型電子線マイクロアナライザ)
- 材料・製品の破損、不良原因調査
- 多電極系での異種金属間接触腐食試験 [事例集PDF]
- SIP 内部熱応力解析
JFE-TEC Newsバックナンバー
- No.52(2017年7月)カーエレクトロニクス分野における分析・解析技術 ~電子機器におけるはんだ接合部の分析・解析~
- No.52(2017年7月)電子基板の欠陥検出 ~電子基板の防湿コーティング欠陥検査装置~
- No.45(2015年10月)蛍光撮像によるコーティング欠陥検査
- No.36(2013年7月)電気・電子部品の腐食亀裂試験 ~UL認証取得のための腐食試験~
このページに関する
お問い合わせはこちらから
- JFEテクノリサーチ株式会社 営業本部
- 0120-643-777