JFE-TEC News
KTEC News
No.32 インレンズ型FE-SEMで見たLSIの内部配線
“KTEC News”は、旧・川鉄テクノリサーチ(株)が年4回発行していた小冊子です。バックナンバーとして掲載しておりますが、現在お取り扱いしていない製品・サービスの場合もございますので、ご了承ください。
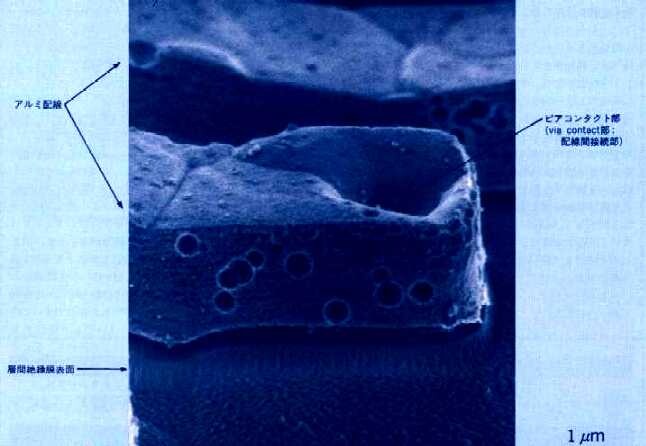
インレンズ型の電界放射型走査電子顕微鏡(インレンズ型FE-SEM)では、高倍率観察ができるだけでなく、蒸着などの導電処理を施さないで試料表面を全くそのままの状態で観察が可能である。電子の加速電圧が低い場合の分解能が優れており、微細化、高集積化が進むLSI(Large Scale Integrated Circuit:大規模集積回路)分野では欠かせない装置となっている。
上の写真はLSI に使われているアルミニウム配線部分をインレンズ型FE-SEMで観察したものである。パッシベーション膜(保護膜)をプラズマ中でエッチングし、さらに薄いフッ酸で処理したアルミ配線をそのままの状態で観察している。配線形状、微小な段差やエッチング時にできたと考えられる配線側面のボイドや凹みが明瞭に確認できる。
LSI は、単結晶Si基板上に微小なトランジスターを形成した後、各トランジスタを繋いで回路を作成するために絶縁膜と配線膜を何層かに積み重ね、最後に保護膜で覆って作られている。最近では5層配線のLSIまで登場してきているが、多層配線構造では各配線膜の平坦性や層間絶縁膜に穴を開けるスルーホールに関わる技術がLSIの性能を左右しているとも言われている。
今回示したような観察技術は、配線間の境界面や配線とシリコン基板の接合界面をはじめ、微細化が進んでいるトランジスタ形状などの観察に応用されており、今後ともLSI 技術発展への寄与が期待されている。
このページに関する
お問い合わせはこちらから
- JFEテクノリサーチ株式会社 営業総括部
- 0120-643-777


