プレスリリース
2025年06月10日
1分以内で300 mmウエハー厚みを100万点計測&分布マッピング - 膜厚分布測定装置FiDiCa®ラインナップ拡充 -
半導体製造のさらなる微細化に向けてウエハー研磨の精度向上・高効率化をサポート
JFEテクノリサーチは、光干渉を用いてフィルムや被膜、液膜などの膜厚分布を非接触で高速・高精細にマッピングできる二次元膜厚分布測定装置FiDiCa®に、シリコンウエハーなど厚みのある基材の厚みも測定可能な極厚膜モデルを開発、投入しました。
【背景】
AIの普及などによって半導体にはより高い演算能力と省電力性が求められ、さらなる高集積化が進んでいくと予想されます。高集積化を実現するには微細な配線や多層構造を正確に形成する必要があり、ウエハー表面の平坦性がこれまで以上に重要となっています。高精度な研磨工程(CMP:化学的機械研磨)は微細加工の基板を整える役割を担うため、回路の断線や短絡の防止に不可欠です。研磨精度の向上には、研磨前の高精細なウエハー厚み分布を正確に測定し、その測定データをもとに研磨加工することでウエハーを均一な厚みに揃える手法が注目を集めており、これに適した厚み分布測定技術の需要が高まっています。
【特長】
JFEテクノリサーチは、長年培ってきた分光カメラ技術を用いた光干渉方式の膜厚分布測定装置FiDiCa®を製造販売しており、これまで100 µm以下のフィルムや被膜、液膜などの膜厚分布測定のニーズに応えてきました。当社では技術改良を重ね、シリコン厚み800 µm(0.8 mm)まで測定できるモデルを開発。シリコンウエハーの厚み分布測定に適用可能なFiDiCa®極厚膜モデルをラインナップに加えました。直径300 mmのシリコンウエハーの場合、0.3 mm間隔で約100万点の厚み計測と、このデータによる厚み分布のマッピング表示を1分以内で終えることができ、かつ目的に応じて0.1 nm ~ 10 nmまで厚み分解能を選択して計算できる機能を有しており、短時間で高精細な厚み分布を測定できます。
【今後の展望】
JFEテクノリサーチでは、FiDiCa®極厚膜モデルで計測したデータをもとに研磨加工を行っていただくことで従来よりも平坦度の高いウエハーの供給に貢献できると考えております。CMPなどのウエハー研磨工程や検査工程、さらには研磨加工機に組み込むなど、ウエハーに関連する幅広い分野で活用され、半導体のさらなる高集積化に寄与していくことを期待しています。
JFEテクノリサーチのFiDiCa®極厚膜モデルについて
JFEテクノリサーチが提供するFiDiCa®は、従来は高速全面測定ができなかった20 µm ~ 800 µmのバルクウエハー、フィルム、ガラス基板などを特殊な光学系と独自アルゴリズムにより測定を可能とし、デバイス業界のニーズにお応えします。
| 薄膜用 | 厚膜用 | 極厚膜用 (ラインナップに追加) |
|
| 測定可能範囲 | 50 nm ~ 20 µm | 1 um ~ 150 µm | 20 µm ~ 800 µm |
| 測定点数 | 約400万点 | 約150万点 | 約100万点 |
| 用途 | SiO2膜、スパッタ膜、レジスト、液膜 | フィルムや水晶など | ウエハーやガラスなど |
ウエハー膜厚分布測定における従来法と膜厚分布測定装置FiDiCa®の比較
| <従来法>エリプソメトリ(エリプソメータ―)/分光干渉膜厚計 | 膜厚分布測定装置FiDiCa® |
|---|---|

点測定をX-Y2軸でスキャンしながら膜厚データを取得。 |

面での測定(ラインスキャン)によって、全面での膜厚データ取得が可能。 |
| 測定点数例:1万点 | 測定点数例:100万点 |
| 測定時間例:1時間以上 | 測定時間例:1分以内 |
| 測定方法:X-Y2軸スキャン | 測定方法:1軸 |
シリコンバルクウェハーの測定例(6インチ)
-

外観写真 -
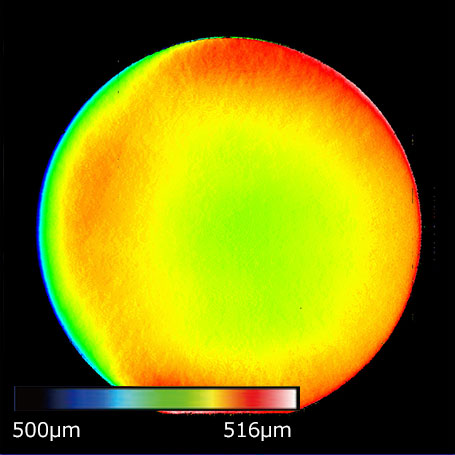
膜厚分布図
詳細は下記ホームページをご覧ください。
https://www.jfe-tec.co.jp/product/hikari/FiDiCa.html
関連リンク・関連記事
このページに関する
お問い合わせはこちらから
- JFEテクノリサーチ株式会社 営業総括部
- 0120-643-777


