JFE-TEC News
No.06「イオンで量る(1)」
JFE-TEC News No.06号 ナノオーダーの元素分析を実現した極低加速SEM-EDS 他 記事一覧

全文 PDF (412.4 KB)
No.06 ナノオーダーの元素分析を実現した極低加速SEM-EDS 他
イオンで量る(1)~イオンを用いた微細加工~
イオンで量るとは?
イオンは電荷を帯びた原子であり、物質との相互作用が大きいことを利用すると、材料を調べるための試料加工をすることができます。また、イオン毎で異なる質量を有していることを利用すると、その元素を特定できますし、量を分析できます。今回のシリーズでは、イオンを用いてこのような分析・解析する技術を解説します。
イオンで削る:FIB
ナノスケールの構造制御を行って機能を発揮させる材料の構造解析を行うため、電子顕微鏡の技術は欠かせないものとなっています。従来の電解研摩、イオンミリングなどの方法では、試料内部に隠れたミクロン以下の薄膜や欠陥の構造を電子顕微鏡観察するための試料を作成することが困難でした。フォーカスドイオンビーム装置(Focused Ion Beam:FIB)は、このような微細な試料の作製装置として重要なものとなっています。図に示すようにFIBは、Gaイオンを細く絞って走査しながら照射し、試料表面近傍の特定部位をイオンスパッタして穴を掘って加工するための技術です。FIBで加工することにより、表面から観ることのできない内部に隠れた構造の断面をSEM(走査電子顕微鏡)や、TEM(透過電子顕微鏡)で観察できるようになります。
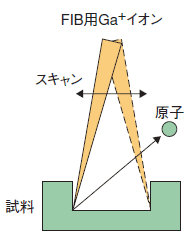
図 FIBによる試料加工
イオンで観る:SIM
Gaイオンを照射した際に放出される2次電子を像(ScanningIon Microscope image:SIM像)として観察すると、分析したい部分を確認しながら加工することができます。特に、SIM像には、観察対象の結晶構造や配向性を反映したコントラストがつく特徴があることから、微細な結晶組織観察にも有用です。写真は、はんだ接合部の断面をSIMで撮影したもので、めっき組織が観察できています。
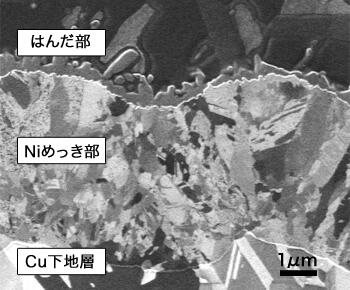
写真 アスベスト(クリソタイル)のSEM写真
このページに関する
お問い合わせはこちらから
- JFEテクノリサーチ株式会社 営業総括部
- 0120-643-777


