JFE-TEC News
No.08「イオンで量る(3)」
JFE-TEC News No.08号 土壌オンサイト分析 他 記事一覧

全文 PDF (482.7 KB)
No.08 土壌オンサイト分析 他
イオンで量る(3)~イオンを用いた固体表面の分析~
固体へのイオン照射を利用した分析法
高エネルギーのイオンを固体試料に照射すると表面から原子がはぎ取られるスパッタリング現象が生じます。グロー放電で発生した高エネルギー粒子により、試料表面の粒子がスパッタリングされるとともに発する光を測定する方法がグロー放電発光分光分析法(Glow Discharge Spectroscopy: GDS)です。また、二次イオン質量分析法(Secondary Ion Mass Spectrometry: SIMS)では、超高真空中に置かれた試料に一次イオンを照射し、スパッタされた二次イオンの質量を分析します。スパッタリングは表面数nmで生じるため、GDSやSIMSは表面に敏感です。スパッタリングは連続的に生じるため、表面から元素の深さ方向の分布も測定できます。
GDSによる迅速深さ方向分析
GDSは、数mm程度の面積に10ppm程度以上含まれる元素の簡易で迅速な深さ方向分析法として、金属材料や半導体材料の分析に用いられています。図1は表面に酸化皮膜が生成したステンレス鋼を測定した例です。表面では母材と異なり、クロムが多いことや、マンガンやシリコンも濃化していることもわかります。このような結果が1分以内で得られることから、工程管理にも用いられています。最近では、高周波放電を利用したGDSを用いることにより、絶縁物皮膜の測定も可能となっています。
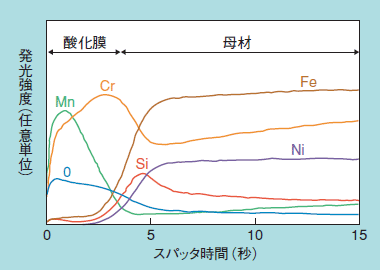
図1 表面に酸化皮膜が生成したステンレス鋼のGDSによる深さ方向分析結果
SIMSを用いた微量元 素の分布観察
SIMSを用いると、水素からウランまでの全元素を高感度(ppm~ppb)で検出することができます。金属材料や半導体デバイスなど様々な材料における元素の深さ方向分布を調べるため、広く使われています。さらに、ミクロン程度の微小部に存在する元素の分布を調べることもできます。その例として、ボロンが10ppmと微量に添加された鋼の観察結果を図2に示します。結晶粒界に偏析したボロンが、網目状の明るい線状のコントラストとして観察されています。このような極微量添加元素であってもSIMSなら観察することができます。
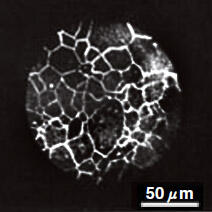
図2 10ppmボロン添加鋼における粒界偏析したボロンのSIMSによるマッピング
(観察視野:円形部分)
このページに関する
お問い合わせはこちらから
- JFEテクノリサーチ株式会社 営業総括部
- 0120-643-777


