物理分析
Cs補正STEM、TEMを用いたSiC系パワーデバイスMOSFETの
ゲート酸化膜/SiC界面のEELS・EDX分析
原子スケールでのゲート酸化膜/SiCウエハ界面近傍の元素分布・化学状態を解明
- Cs補正STEM(収差補正型走査透過電子顕微鏡)、TEMを活用することにより、パワーデバイス用ゲート酸化膜/SiCウエハ界面近傍の化学状態(C(炭素)、O(酸素)、Si(ケイ素))や元素分布を解析できます。
- 薄膜・表面処理/基板界面における原子スケールでの解析も可能です。
分析事例
Cs補正STEM-EDX-EELSは、1nm以下の界面の元素分布・化学状態の評価が可能なため、SiO2酸化皮膜が形成された4H-SiCにおいて、EDX線分析より、SiC基板とSiO2との界面幅が1nm以下と急峻であること、EELSスペクトルから、界面でSiと結合していないCもわずかに存在することがわかります。
-

EDX線分析 -
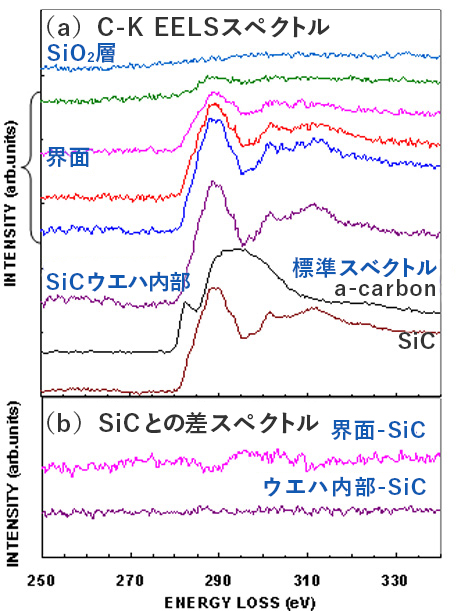
炭素のEELSによる化学状態分析
試料ご提供:奈良先端科学技術大学 矢野先生
作業の流れ

関連ページ・関連リンク
- 薄膜・表面処理に関する分析
- バルクの化学状態分析
- 電子材料・半導体の構造解析
- 電子部品、電子デバイスの解析・調査
- 高感度EDX搭載TEMによるパワーデバイス用酸化膜界面の分析 [事例集PDF]
- パワーデバイス用ゲート酸化膜/SiCウエハ界面の清浄性評価 [事例集PDF]
- パワーデバイス用SiC/SiO2界面のナノスケール解析技術 [事例集PDF]
- パワーデバイス用チップの微細構造観察技術 [事例集PDF]
このページに関する
お問い合わせはこちらから
- JFEテクノリサーチ株式会社 営業総括部
- 0120-643-777


