電子部品、電子デバイスの解析・調査
IC/LSI製品の不具合事例
端子間イオンマイグレーション [IC製品の短絡不具合事例]
-
Agは硫黄化合物ガス*等に腐食され易いため、パッケージ外部にAgめっき部(銀めっき部)が露出しないようにパッケージングされています。
PKG樹脂(パッケージ樹脂)の外部にリードフレームのAgめっきが露出している場合、Agが腐食し、Agがイオンマイグレーション(端子間に電位差がある場合)することにより、端子間が短絡(ショート)します。なお、腐食は、湿度の高い環境ほど加速されます。
*硫黄化合物ガスは、地域及び使用環境により、微量に存在していることがあります。
-
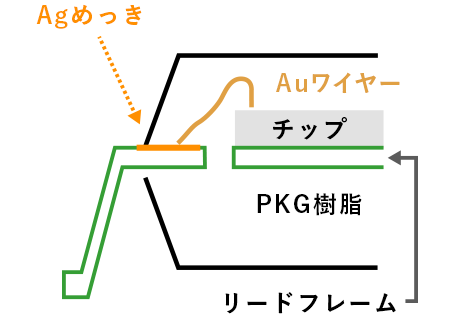
Agめっきが露出している場合
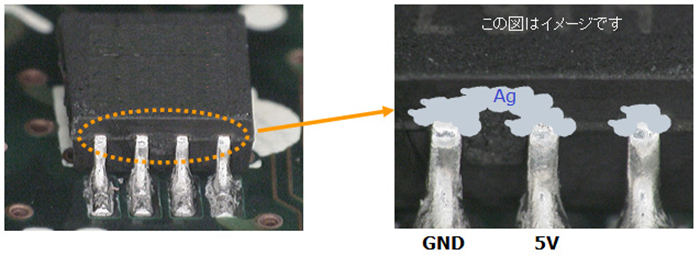
チップ/PKG樹脂剥離 [LSI製品のオープン不具合品事例]
-
プリント基板実装後のLSI製品に不具合が発生した事例です。
超音波顕微鏡(SAT)によりチップと樹脂との境界剥離を観察した結果、チップ/PKG樹脂(パッケージ樹脂)界面に剥離が確認されました。右写真(上)でチップの下側が白く見えている箇所が剥離していることを示しています。
PKG樹脂が吸湿していため、リフロー時の急激な加熱により水蒸気爆発(ポップコーン現象)が発生し、それに伴いワイヤー断線に至ったと推測されます。
-
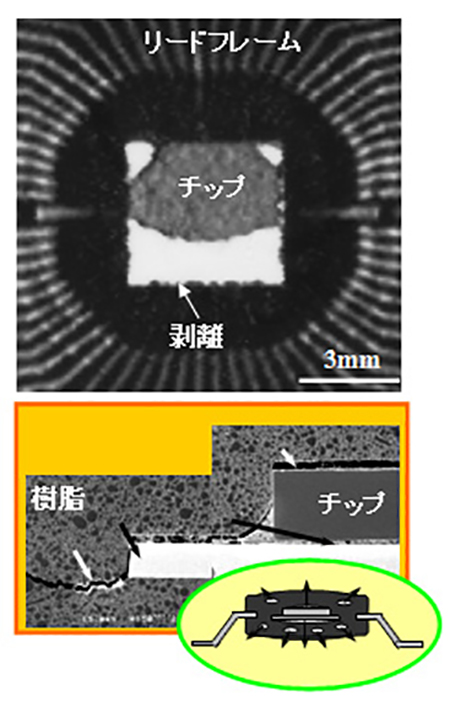
チップ/パッケージ樹脂界面
Auワイヤ(金ワイヤ)不具合 [LSI製品のオープン不具合品事例]
-
製品受入検査時に不具合確認されました。
透過X線観察(マイクロフォーカスX線)により内部のAuワイヤ(金ワイヤ)を観察した結果、1stボンディングのネック部において破断が確認されました。(写真・右上でAuワイヤがネックの部分で断線していることがわかります。)
Auワイヤの断線は、リフロー時のポップコーン現象(樹脂/チップ界面剥離)、ボンディング不具合などにより発生することがあります。
-
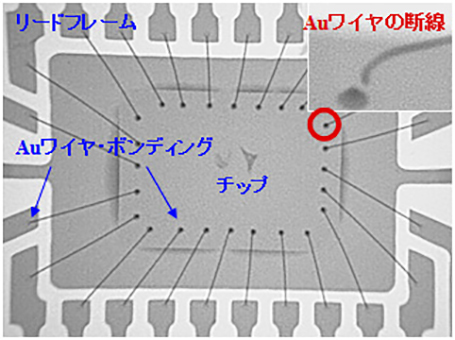
ICチップの透過X線観察
過電流破壊(EOS破壊) [LSI製品のオープン不具合品事例]
市場で多く使用されるトランジスタ製品において不具合が発生した事例です。
この製品はパワーMOSFETで、I-V特性を測定した結果、ゲート、ソース、ドレイン間の全てにおいて短絡(ショート)していました。このトランジスタ部品のモールド樹脂を開封して内部観察した結果、FETチップ左上付近に丸い黒く見える溶融痕跡が確認されました。一般的にEOS破壊と呼ばれる過電流や過電圧で破壊された際に、このような特徴を示すことが分かっています。したがってこの製品もEOS破壊であることがわかります。
-
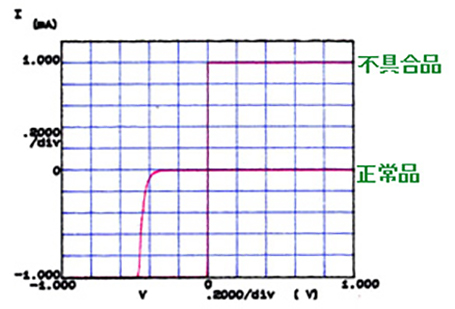
FETチップのドレイン-ソース間の電圧電流特性 -
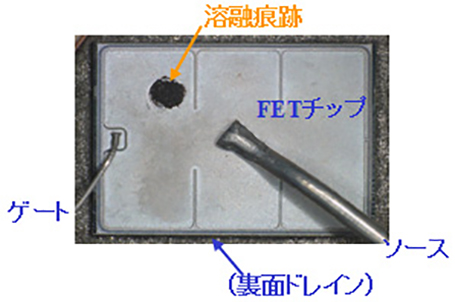
FETチップの開封観察結果
内部アルミ配線腐食 [IC、トランジスタの故障解析事例]
下図は、ある電子基板で動作が不安定な挙動をしているため、関係するIC部品の調査をした事例です。
左のグラフは、いくつかの端子の電気特性を測定した結果ですが、1pin(高抵抗)になっていることが確認できます。このことからは、1pinの配線や接続部で異常が発生していることが予想されます。
IC製品のモールド樹脂を溶解し、チップ表面を観察した写真が右の写真です。赤く丸で囲んだ領域では、ICチップ内1pinのアルミ配線が変色していることが確認できます。
一般的に、アルミ配線(Al 配線)が腐食により、酸化したり水酸化することで、このように見えることが知られており、腐食によりアルミ配線の高抵抗化が進行したため、動作の不具合に至っていることが分かります。
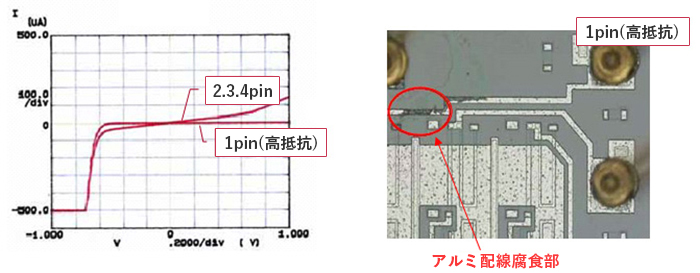
作業の流れ

関連リンク・関連記事
JFE-TEC Newsバックナンバー
- No.36(2013年7月)電気・電子部品の 腐食亀裂試験 ~ UL認証取得のための腐食試験~
- No.29(2011年10月)ガス腐食試験 ~低濃度ガス腐食試験による電子部品の信頼性評価~
- No.15(2008年4月)電子材料(2)~電子部品の故障解析・信頼性試験(2)~
- No.14(2008年1月)電子材料(1)~電子部品の故障解析・信頼性試験~
このページに関する
お問い合わせはこちらから
- JFEテクノリサーチ株式会社 営業総括部
- 0120-643-777


